Search
Search Results
-
Metasurface array for single-shot spectroscopic ellipsometry
Spectroscopic ellipsometry is a potent method that is widely adopted for the measurement of thin film thickness and refractive index. Most...

-
Ellipsometry
Ellipsometry, in general, determines the complex ratio ρ of linearly independent electric feld components of polarized electromagnetic plane waves....
-
Dynamic Spectroscopic Imaging Ellipsometry for Thickness Measurement Based on a Dual-Comb System
Lightweight multifunctional devices, such as thin-film antennas and solar sails, are important for lightweight spacecraft development. The thickness...
-
Optical properties of LaFeO3 films studied using spectroscopic ellipsometry
LaFeO 3 film is an intermediate charge transfer/Mott–Hubbard insulator. LaFeO 3 thin films were grown on SrTiO 3 substrates using radio frequency...

-
Determination of Optical Properties of MOVPE-Grown InxGa1-xAs/InP Epitaxial Structures by Spectroscopic Ellipsometry
In x Ga 1−x As epitaxial layers with different AsH 3 flows have been grown on InP substrate with the MOVPE system. It has been found that AsH 3 flow...

-
Spectroscopic ellipsometry studies of optical properties of TlIn(S0.25Se0.75)2 crystal
The optical properties of TlIn(S 0.25 Se 0.75 ) 2 crystals were studied by ellipsometry measurements. X-ray diffraction pattern presented well-defined...

-
Magneto-Optic Ellipsometry
The free-charge-carrier properties effective mass m, mobility μ, and carrier concentration N are of fundamental importance for understanding basic...
-
Ellipsometry
Ellipsometry is a very sensitiveEllipsometry|textbf technique for the detection of optical properties at surfaces, also getting information on the...
-
Investigation of dual intrinsic a-Si:H films for crystalline silicon surface passivation by spectroscopic ellipsometry: application in silicon heterojunction solar cells
The microstructure factor ( R* ) of the PECVD-grown intrinsic amorphous silicon (i-a-Si:H) layer plays a crucial role in crystalline silicon (c-Si)...

-
Study on TiN film growth mechanism using spectroscopic ellipsometry
We performed an ellipsometric study of TiN films on Si substrate to determine optimal conditions for TiN deposition, which is one of main processes...

-
Investigation of Dielectric Functions of a Layer of Ag Nanoparticles on Silicon Using Spectro-Ellipsometry and Spectrophotometry
AbstractAn investigation of the optical characteristics of a layer of Ag nanoparticles deposited from an AgNO 3 solution on the surface of...

-
Spectroscopic ellipsometry and solar cell performance of Cs-doped MA0.05FA0.95Pb(I0.98Br0.02)3 triple cation perovskite thin films for solar cell applications
FA 0.95 MA 0.05 Pb(Br 0.02 I 0.98 ) 3 (CsI) x ( x = 0, 0.02, 0.05, 0.07) thin films were formed in a dry air atmosphere. The influence of different ratios of...

-
Ellipsometry study on silicon nitride film with uneven thickness distribution by plasma-enhanced chemical vapor deposition
As passivation layer and anti-reflection layer, silicon nitride (SiNx) thin film has been widely used in photovoltaic devices such as solar cells....
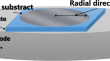
-
Deconvolution of the biexciton structure of monolayer MoSe2 in spectroscopic ellipsometric data: a comparison of maximum-entropy methods
The detection of weak features in spectra remains a challenge. Differentiation remains a standard method, but maximum-entropy filters provide an...

-
Azimuthal angle dependent dielectric function of SnS by ellipsometry
Since α-SnS has optically strong anisotropic characteristics, a simple method to determine its crystal orientation is strongly needed in device...

-
Ellipsometry Techniques and Its Advanced Applications in Plasmonics
Ellipsometry is a versatile optical measurement technique which uses polarized light as a probe to characterize various properties of materials viz....
-
Plasmonic structures for phase-sensitive ellipsometry biosensing: a review
Plasmonic biosensing endeavors to offer the ultrasensitivity below 10 −7 RIU along with providing a label-free platform for the detection of...

-
Electronic structure analysis of a-Si: H p-i1-i2-n solar cells using ellipsometry spectroscopy
In this study, we report an enhancement in the efficiency of a-Si:H solar cells due to the addition of an intrinsic layer. The intrinsic layer of...

-
Spectroscopic ellipsometry characterization of amorphous Se100-xTex films using the Cody–Lorentz parameterized model
The optical properties of a series of Se 100-x Te x ( x = 0, 1, 5, 10, 15, 20, 25 and 35) films have been determined using a variable angle spectroscopic...

-
Machine learning powered ellipsometry
Ellipsometry is a powerful method for determining both the optical constants and thickness of thin films. For decades, solutions to ill-posed inverse...

