Search
Search Results
-
Hybrid Solder Joint for Low-Temperature Bonding Application
Low-temperature bonding has become a significant trend in advanced electronics packaging technology. A low-reflow-temperature process can effectively...

-
Evaluation of high-temperature long-term reliability of transient liquid phase bonded joints using etched Cu foam/Sn–3.0Ag–0.5Cu composite solder preform
This study was aimed at examining the applicability of Cu–Sn system transient liquid phase (TLP) bonding using Cu foam to high-temperature operating...

-
Thermodynamic Assessment of Tin Based Molten Binary Indium-Tin Solder Alloys
It has been focused to develop the lead free solder alloy by substitute the In in place of Pb in Sn-Pb alloy to reduce the harmful effect of lead in...
-
Effect of Zn nanoparticle doped flux on electromigration damages in SAC305 solder joint
Downscaling of electronic devices increased the current density in the solder joint. High current density causes the rapid diffusion of Cu atoms...

-
Effect of Zn nanoparticle-doped flux on mechanical properties of SAC305 solder joint after electromigration
Migration of Cu atoms from the cathode side to the anode side causes void formation in the solder joint, which is the root cause of electromigration...

-
Effect of Cu6Sn5 nanoparticles addition on properties of Sn3.0Ag0.5Cu solder joints
The ever-increasing packaging density of electronic products has led to a dramatic reduction in the dimensions of solder joints, which further...

-
Orientation transformation of Cu6Sn5 grains by Ag addition in Cu/Sn-xAg/Cu micro solder joints under temperature gradient
Cu 6 Sn 5 intermetallic compound (IMC), which occupies most even full of solder joints bringing by the reduced size of interconnection and the...

-
Grain size stability of interfacial intermetallic compound in Ni and Co nanoparticle-doped SAC305 solder joints under electromigration
In Sn-based solder joints, the size of interfacial IMC grains plays an important role in determining the properties of solder joints. An effort has...

-
Effect of (111) oriented nanotwinned Cu substrate on the electromigration of Sn58Bi solder joint at high current density
(111) oriented nanotwinned copper ((111)nt-Cu) has attracted much attention and shown a good application prospect as Under Bump Metallurgy (UBM) in...
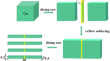
-
Calorimetric measurements of Ga–In, Ga–Sn, and In–Sn binary alloy systems as sustainable lead-free solder alternatives
The main objective in exploring a lead-free solder system comprising Gallium, Indium, and Tin lies in the desire to mitigate health hazards related...

-
Measurement of Mixing Enthalpies for Sn-Bi-Sb Lead-Free Solder System
Predictions of the thermodynamic behavior of higher-order multicomponent alloys from thermodynamic data of binary and ternary systems have been...

-
Frictional metallurgy induced formation and evolution of solder/Cu column interconnect microstructure and properties
A novel friction micro-welding (FMW) technology was used for copper column connection of column grid array (CGA) packaging. The investigation found...

-
Effect of P content on diffusion resistance and interfacial mechanical properties of crystalline Co–P coatings in solder joints
Electroplating crystalline cobalt–phosphorus (Co–P, with 1 ~ 8 at.% P) is a potential interfacial layer for electronic packaging solder joints,...

-
Self-Healing of Kirkendall Voids and IMC Growth in the Interfacial Reaction of Novel Ni/Cu bi-layer Barrier and Solder
Single Ni layer is often inserted as diffusion barrier between Cu pillar and Sn-based solder to avoid excessive growth of brittle intermetallic...

-
Effect of temperature on the electrical conduction and dielectric behavior of solder
Solder is widely used as an electrical conductor in electronics. This paper reports the effect of heating up to 70 °C on the conduction and...

-
Preventing Void Growth Between Ni3Sn4 and Solder
An increasing number of applications of microelectronics products involve multiple reflows and/or extended operation at temperatures high enough that...

-
Electrodeposited Palladium Coating on Co Micro-Nano Cones Array for Low-Temperature Solid-State Bonding
A low-temperature solid-state bonding technology using palladium-coated Co micro-nano cones array (MCA) and Sn-3.0Ag-0.5Cu (wt%) solder was...

-
Wetting and Interfacial Chemistry of New Pb-Free Sn-Zn-Ag-Al-Li (SZAAL) Solder with Cu, Ni, and Al Substrates
This paper presents the results of the Ni substrate wetted with the liquid Sn-Zn eutectic alloy with the addition of Ag, Al, and Li (84.3 at.% Sn,...

-
Interface Reaction between Tin Solder and Nanocrystalline Ni and Ni-Mo Coatings Obtained by Electrodeposition
Nanocrystalline Ni-Mo coatings, obtained by electroplating, were investigated as an alternative barrier layer between the Cu substrate and Sn solder....

-
Electrochemical deposition of Sn-0.7Cu alloy modified with nano-WO3 for high-density mini-LED packaging
In this work, Sn-0.7Cu-WO 3 nanomodified solders were electrodeposited from an aqueous acidic plating bath containing various fractions of WO 3 ...

