Search
Search Results
-
Finite Element-Assisted Assessment of the Thermo-cyclic Characteristics of Leads Soldered with SnAgCu(+Bi,In) Alloys
Solder joints between leads and printed circuit boards in thin small outline packages were produced with conventional Sn1.0Ag0.7Cu (SAC107) and...
-
Effects of nano-SiO2 particles addition on the microstructure, wettability, joint shear force and the interfacial IMC growth of Sn3.0Ag0.5Cu solder
In the present study, the nano-composite solder with SiO 2 nanoparticles into eutectic Sn3.0Ag0.5Cu solder were prepared. The addition concentration...

-
Comparative study of the microstructure and mechanical strength of tin-copper (Sn0.7Cu) solder modified with silver (Ag) by both alloying and do** methods
In order to compare the effectiveness of alloying methods with do** methods, we have studied the microstructure and mechanical strength of Sn0.7Cu...

-
Effect of Solder Joint Length on Fracture Under Bending
Fracture tests were conducted on copper–solder–copper joints of various lengths using double-cantilever-beam (DCB) specimens under mode I loading...
-
Effect of Thermal Aging on the Mechanical Properties of Sn3.0Ag0.5Cu/Cu Solder Joints Under High Strain Rate Conditions
Shear tests with velocities between 0.5 m/s and 2.5 m/s were conducted to investigate the deformation characteristics of 0.76 mm lead-free...
-
Interfacial reaction and IMCs growth behavior of Sn3Ag0.5Cu/Ni solder bump during aging at various temperatures
The interfacial reaction, morphology, and growth behavior of interfacial intermetallic compound (IMC) between the Sn–3Ag–0.5Cu (in wt%) solder and Ni...

-
Prediction of Phase Formation in Nanoscale Sn-Ag-Cu Solder Alloy
In a dynamic nonequilibrium process, the effective heat of formation allows the heat of formation to be calculated as a function of concentrations of...
-
Growth Behavior of Intermetallic Compounds in Cu/Sn3.0Ag0.5Cu Solder Joints with Different Rates of Cooling
The growth behavior of intermetallic compounds (IMC) in Cu/Sn3.0Ag0.5Cu solder joints, including the interfacial Cu 6 Sn 5 layer and Ag 3 Sn, and Cu 6 Sn 5 ...
-
Enhancement of mean-time-to-failure of Sn3.0Ag0.5Cu solder bump joint under current stressing via controlling bump shape
In this research, two different Sn3.0Ag0.5Cu solder bump joints with barrel shape and hourglass shape respectively were fabricated by controlling...
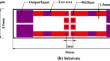
-
Intermetallic growth study at Sn–3.0Ag–0.5Cu/Cu solder joint interface during different thermal conditions
The morphology and growth behaviors of intermetallic compounds (IMCs) of Sn–3.0Ag–0.5Cu/Cu solder joints were investigated during isothermal aging,...

-
Effect of Nd on whiskers growth behavior of SnAgCu solders in electronic packaging
The effects of rare earth Nd on the whisker growth were investigated, it is found that the presence of Nd causes the risk of whisker growth due to...

-
Wetting behaviour of SAC305 solder on different substrates in high vacuum and inert atmosphere
The wettability between solder and substrate is a very important issue in reliability of soldering process. The contact angle θ is used to measure...

-
Effect of nano α-Fe2O3 additions on physical and mechanical properties of Sn–1.0Ag–0.7Cu–xFe2O3 low Ag lead-free solders
In this study, the α-Fe 2 O 3 nanoparticles were successfully fabricated by chemical method. Smelting technique has been used to prepare the...

-
Effect of the Silver Content of SnAgCu Solder on the Interfacial Reaction and on the Reliability of Angle Joints Fabricated by Laser-Jet Soldering
The silver content of lead-free solders affects their microstructure, the interfacial reaction, and the performance of the joints in reliability...
-
Interfacial Reaction Between Sn3.0Ag0.5Cu Solder and ENEPIG for Fine Pitch BGA by Stencil Printing
In this work, solder balls in ball grid array packaging technology with the pitch of 300 μ m were fabricated by stencil printing solder paste and then...
-
The effects of Mn powder additions on the microstructures and tensile property of SnAgCu/Cu solder joints
In this paper, the effects of Mn powder on fusion property of Sn3.0Ag0.5Cu solder alloy and microstructures as well as tensile property of the...

-
Effect of TiO2 addition concentration on the wettability and intermetallic compounds growth of Sn3.0Ag0.5Cu–xTiO2 nano-composite solders
In the present study, addition of TiO 2 nanoparticles with a concentration in the range from 0 to 0.75 wt% into eutectic Sn3.0Ag0.5Cu solders were...

-
Effects of temperature and strain rate on mechanical behavior of low-silver lead-free solder under drop impact
This study uses finite element program to simulate the process of board-level drop for portable electronic devices, so as to create...

-
Effect of BaTiO3 on the microstructure and mechanical properties of Sn1.0Ag0.5Cu lead-free solder
Minor weight fraction of the BaTiO 3 particle is doped into the Sn1.0Ag0.5Cu (SAC) lead-free solder by the mechanically mixing. The effect of BaTiO 3 ...

-
Creep failure mechanism and life prediction of lead-free solder joint
The reliability of solder joints in electronic products has received a lot of concern. The creep behavior is an important property for lead-free...

