Search
Search Results
-
Recent progress of Sn–Ag–Cu lead-free solders bearing alloy elements and nanoparticles in electronic packaging
Sn–Ag–Cu lead-free solders, containing alloy elements and nanoparticles, have been extensively investigated. With the extensive prevalence of 3D IC...

-
Electromigration and Thermomechanical Fatigue Behavior of Sn0.3Ag0.7Cu Solder Joints
The anisotropy of Sn crystal structures greatly affects the electromigration (EM) and thermomechanical fatigue (TMF) of solder joints. The size of...
-
Mass transport phenomena in copper nanowires at high current density
Electromigration in Cu has been extensively investigated as the root cause of typical breakdown failure in Cu interconnects. In this study, Cu...

-
Polarized evolution of interfacial intermetallic compounds (IMCs) in interconnects under electromigration (EM)
In situ observation of electromigration (EM) has been carried out on cross-sectioned copper/tin–copper/copper (Cu/Sn0.7Cu/Cu) line-type...

-
Influence of Gaseous Media Flow in the Dual Ar-H2-H2O/air Atmosphere Setup on the Scale Growth Kinetics of Crofer 22APU Ferritic Stainless Steel
The problem of gaseous media distribution within the metallic interconnects in solid oxide fuel cells (SOFCs) and its influence on the oxidation...

-

-
Degradation behaviors of micro ball grid array (μBGA) solder joints under the coupled effects of electromigration and thermal stress
Due to the complicated configuration of real micro ball grid array (μBGA) package, kinds of physical failure mechanisms occurs and mixed together in...

-
Microstructural Evolution of Intermetallic Compounds in TCNCP Cu Pillar Solder Joints
This study investigated the microstructure, especially intermetallic compounds (IMCs), formed between a Cu pillar and Cu trace joined by thermal...
-
Vanadium Monocarbide
Vanadium forms with carbon plenty of chemical compounds (see also section C – V in Table I-2.13): vanadium monocarbide VC1–x having the broad...
-
In situ study on Cu-Ni cross-interaction in Cu/Sn/Ni solder joints under temperature gradient
Synchrotron radiation real-time imaging technology was performed to in situ study the Cu-Ni cross-interaction in Cu/Sn/Ni solder joints under...

-
Electromigration in Cu-Cored Sn-3.5Ag-0.7Cu Solder Interconnects Under Current Stressing
The effect of electromigration in Cu-cored Sn-3.5Ag-0.7Cu solder interconnects under current stressing was investigated. After current stressing at a...
-
Materials challenges in three-dimensional integrated circuits
In the present era of big data and the Internet of things (the interconnection of computing devices in the Internet infrastructure), the fabrication...

-
Enhancement of mean-time-to-failure of Sn3.0Ag0.5Cu solder bump joint under current stressing via controlling bump shape
In this research, two different Sn3.0Ag0.5Cu solder bump joints with barrel shape and hourglass shape respectively were fabricated by controlling...
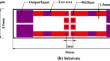
-
Titanium Monocarbide
Similarly to other transition metals of group 4 – hafnium and zirconium, titanium forms with carbon, practically, the only one chemical compound (see...
-
Effect of Grain Boundary Misorientation on Electromigration in Lead-Free Solder Joints
Reduction in microelectronic interconnect size gives rise to solder bumps consisting of few grains, approaching a single- or bicrystal grain...
-
Growth of skyrmionic MnSi nanowires on Si: Critical importance of the SiO2 layer
MnSi in the B20 structure is a prototypical helimagnet that forms a skyrmion lattice, a vortex-like spin texture under applied magnetic field. We...

-
Effect of TiO2 addition concentration on the wettability and intermetallic compounds growth of Sn3.0Ag0.5Cu–xTiO2 nano-composite solders
In the present study, addition of TiO 2 nanoparticles with a concentration in the range from 0 to 0.75 wt% into eutectic Sn3.0Ag0.5Cu solders were...

-
Evaluation of Electromigration Behaviors of Pb-Free Microbumps in Three-Dimensional Integrated Circuit Packaging
This study investigated electromigration (EM) behaviors of Pb-free microbumps in three-dimensional integrated circuit (3D IC) packaging under...
-
Microstructure Evolution of Cu-Cored Sn Solder Joints Under High Temperature and High Current Density
This work investigated the microstructure evolution of Cu-cored Sn solder joints under high temperature and high current density. The Cu 6 Sn 5 phase...
-
Electromigration in Sintered Nanoscale Silver Films at Elevated Temperature
Sintered nanoscale silver is a promising interconnection material for semiconductor devices because it provides improved joint properties compared...
