Search
Search Results
-
A review of intermetallic compound growth and void formation in electrodeposited Cu–Sn Layers for microsystems packaging
In recent years, Cu–Sn solid–liquid interdiffusion (SLID) bonding has been used in semiconductor packaging, die-attach, fine-pitch interconnection,...

-
Microstructures and Mechanical Properties of the Sn58wt.%Bi Composite Solders with Sn Decorated MWCNT Particles
The mechanical properties and microstructures of Sn58Bi (in wt.%) composite solders with Sn decorated multiwalled carbon nanotube (Sn MWCNT)...
-
Nano-materials in Anisotropic Conductive Adhesives (ACAs)
Display-related electronics such as smartphones, laptops, and UHD TVs have become an indispensable part of our lives. In line with this, as people...
-
Morphologies and evolution of intermetallic compounds formed between Sn1.0Ag0.7Cu composite solder and Cu substrate
AbstractThis study investigated the morphologies of the intermetallic compounds (IMC) formed during soldering reaction between Sn1.0Ag0.7Cu–1.0SnO 2 ...

-
Morphology and Shear Strength of Lead-Free Solder Joints with Sn3.0Ag0.5Cu Solder Paste Reinforced with Ceramic Nanoparticles
To date, additions of different oxide nanoparticles is one of the most widespread procedures to improve the mechanical properties of metals and metal...
-
Effect of the Angle Between Sn Grain c-Axis and Electron Flow Direction on Cu-Reinforced Composite Solder Joints Under Current Stressing
With a body-centered tetragonal crystal structure, Sn grains were demonstrated to have highly anisotropic behaviors in various properties. The...
-
The growth behavior of interfacial intermetallic compound between Sn–3.5Ag–0.5Cu solder and Cu substrate under different thermal-aged conditions
The interfacial reaction, morphology, activation energies and growth behavior of interfacial intermetallic compounds (IMCs) between the Sn–3Ag–0.5Cu...

-
A Study of Nanoparticles in SnAg-Based Lead-Free Solders
Tin-lead (Sn-Pb) solder alloy has been widely used as interconnection material in electronic packaging due to its low melting temperatures and good...
-
An improved unified creep-plasticity model for SnAgCu solder under a wide range of strain rates
Based on the unified creep and plasticity theory, an improved constitutive model is proposed in this study to describe the uniaxial mechanical...

-
Effects of anisotropy of tin on grain orientation evolution in Pb-free solder joints under thermomechanical stress
In this paper, the grain orientation evolution of Pb-free solder joints during thermomechanical fatigue (TMF) was characterized quantitatively using...

-
Effects of nanoparticles on the thermal, microstructural and mechanical properties of novel Sn3.5Ag0.5Zn composite solders
The effects of added nanoparticles (i.e., Al 2 O 3 and TiO 2 ) on the thermal, microstructural and mechanical properties of Sn3.5Ag0.5Zn nanocomposite...

-
Nanocomposite SAC Solders: The Effect of Adding Ni and Ni-Sn Nanoparticles on Morphology and Mechanical Properties of Sn-3.0Ag-0.5Cu Solders
This study investigates the effect of minor additions of Ni, Ni 3 Sn or Ni 3 Sn 2 nanoparticles on the microstructure and mechanical properties of...
-
An investigation on the ZnO retained ratio, microstructural evolution, and mechanical properties of ZnO doped Sn3.0Ag0.5Cu composite solder joints
In this study, ZnO nanoparticles with different weight fractions (0.1, 0.25, 0.5 and 1 wt%) were successfully incorporated into Sn3.0Ag0.5Cu (SAC305)...

-
Effect of initial Cu concentration on the IMC size and grain aspect ratio in Sn–xCu solders during multiple reflows
The effect of initial Cu concentration in Sn–xCu solders, on grain size and morphology of interfacial intermetallic compound (IMC) during multiple...

-
Study on Subgrain Rotation Behavior at Different Interfaces of a Solder Joint During Thermal Shock
In order to investigate subgrain rotation behavior in the recrystallized region of lead-free solder joints, a ball grid array (BGA) specimen with a...
-
Aging resistance and mechanical properties of Sn3.0Ag0.5Cu solder bump joints with different bump shapes
The effects of bump shape on the aging resistance and mechanical properties of Sn3.0Ag0.5Cu (SAC) solder bump joints were investigated by...
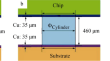
-
Development of SnAgCu solders with Bi and In additions and microstructural characterization of joint interface
Properties of lead-free solder alloys and microstructural characterization of solder joints made from Sn1.0Ag0.5Cu1.0Bi and Sn0.9Ag0.5Cu0.9Bi1.0In...

-
Mechanistic Prediction of the Effect of Microstructural Coarsening on Creep Response of SnAgCu Solder Joints
Mechanistic microstructural models have been developed to capture the effect of isothermal aging on time dependent viscoplastic response of...
-
Reliability study of industry Sn3.0Ag0.5Cu/Cu lead-free soldered joints in electronic packaging
The wettability of Sn3.0Ag0.5Cu on copper substrate with different reflow temperature was studied. The growth mechanism of intermetallic compound...
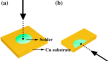
-
Subgrain rotation at twin grain boundaries of a lead-free solder joint during thermal shock
A ball grid array specimen with cross sectioned edge row was thermally shocked to investigate subgrain rotation of recrystallized region in lead-free...

