Search
Search Results
-
Investigation on shear fracture of different strain rates for Cu/Cu3Sn/Cu solder joints derived from Cu–15μm Sn–Cu sandwich structure
Full intermetallics (IMCs) solder joints are of great significance to electronic packaging technology. In this paper, some efforts have been made for...

-
Effect of deep cryogenic treatment on mechanical properties and microstructure of Sn3.0Ag0.5Cu solder
The effect of deep cryogenic treatment on the performance of steels and alloys has attracted wide attention in the past decades. Deep cryogenic...

-
Subgrain Rotation Behavior in Sn3.0Ag0.5Cu-Sn37Pb Solder Joints During Thermal Shock
Ball grid array (BGA) samples were soldered on a printed circuit board with Sn37Pb solder paste to investigate the recrystallization induced by...
-
Influences of different barrier films on microstructures and electrical properties of Bi2Te3-based joints
Diffusion barrier film was strongly proposed to utilize in Bi 2 Te 3 -based thermoelectric (TE) module. However, effects of different barriers on...

-
Size effect on microstructure and tensile properties of Sn3.0Ag0.5Cu solder joints
In the current study, the size effect on microstructure and tensile property of Sn3.0Ag0.5Cu (SAC305) solder joint is investigated. Experiments were...
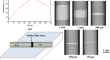
-
Size effects on the interfacial reaction and microstructural evolution of Sn-ball/Sn3.0Ag0.5Cu-paste/Cu joints in board-level hybrid BGA interconnection at critical reflowing temperature
The effects of solder joint size on the interfacial reaction and microstructural evolution of Sn-ball/Sn3.0Ag0.5Cu-paste/Cu joints in board-level...

-
Structure and properties of low-Ag SAC solders for electronic packaging
Since the high cost of Ag, current research on traditional high-Ag solders has gradually shifted to low-Ag solders. However, the microstructure tends...

-
Effects of impurities on double twinning nucleation and grain refinement of Sn-based solder joints
As-solidified Sn3.0Ag0.5Cu + 3.0POSS (polyhedral oligomeric silsesquioxanes), Sn3.0Ag0.5Cu + 0.05CNTs (carbon nanotubes) and Sn3.0Ag3.0Bi3.0In...

-
Synergetic effect of strain rate and electroplated Cu film for shear strength of solder/Kovar joints
The effects of strain rate and electroplated Cu on the shear fracture behaviors of Sn37Pb/electroplated Cu (EPC)/Kovar solder joints were...

-
Dependence of grain orientation in SABI333 solder joints on solidification temperature
Electron backscattered diffraction was employed to observe the orientations of as-solidified Sn3.0Ag3.0Bi3.0In (SABI333) joints. Unlike other...

-
Influences of Mono-Ni(P) and Dual-Cu/Ni(P) Plating on the Interfacial Microstructure Evolution of Solder Joints
The interfacial microstructures of Sn-3.0Ag-0.5Cu (SAC305) solder systems with thin Ni(P) mono-coatings and Cu-Ni(P) dual-coatings were investigated...

-
An Arrhenius-type constitutive model to predict the deformation behavior of Sn0.3Ag0.7Cu under different temperature
Using the fatigue test machine, the isothermal compression of low-silver lead-free solder Sn0.3Ag0.7Cu at the temperature of 40 °C, 80 °C, 120 °C,...

-
Optimal Design of Co/In/Cu Sputtering Target Assembly Using Finite Element Method and Taguchi Method
Target assembly is a key consumable material for producing thin film used in the electronic packaging and devices. The residual stresses induced...

-
Interface reaction and intermetallic compound growth behavior of Sn-Ag-Cu lead-free solder joints on different substrates in electronic packaging
During soldering and service, intermetallic compounds (IMCs) have an important impact on the performance and reliability of electronic products. A...

-
Nucleation and electromigration-induced grain rotation in an SABI333 solder joint
Single-grain or tricrystal joints are often observed in Sn-based Pb-free solder alloys, such as Sn3.5Ag and Sn3.0Ag0.5Cu, and Sn dendrites tend to...

-
Correlation Between the Growth of Voids and Ni3Sn4 Intermetallic Compounds at SnAg/Ni and SnAgCuBiSbNi/Ni Interfaces at Temperatures up to 200°C
The increased demand for microelectronic devices that function in hotter environments compels the study of Pb-free solders containing solid solution...
-
Effects of β-Sn grain c-axis on electromigration behavior in BGA Sn3.0Ag0.5Cu solder interconnects
The anisotropy of β -Sn grain can significantly affect the electromigration (EM) behavior in Sn3.0Ag0.5Cu (SAC305) solder interconnects. A real ball...

-
Co-P Diffusion Barrier for p-Bi2Te3 Thermoelectric Material
(Bi 0.25 Te 0.75 ) 2 Te 3 (p-Bi 2 Te 3 ) is thermoelectric material that can harvest waste heat into useful electric power. A severe reaction between p-Bi 2 Te 3 ...
-
Recrystallized grain rotation behavior in a Pb-free BGA solder joint under electron current stress
The grain orientations of a Pb-free ball grid arrays solder joint after thermomechanical fatigue (TMF) were characterized quantitatively using...
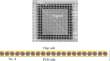
-
Effects of Sn grain c-axis on electromigration in Cu reinforced composite solder joints
Sn grain orientation in solder matrix has recently been considered as one of the principal failure contributions in lead-free solder joints. Since β -S...

