Search
Search Results
-
Research on Microstructure and Shear Behavior of Au/Sn-Ag-Cu/Cu Lead-free Solder Joints at Different Soldering Temperatures
In the actual production process, soldering is a key step in the flip-chip packaging process. The reliability of the interconnection interface of...

-
Research on the Mechanical and Performance Effects of Flux on Solder Layer Interface Voids
This article focuses on the study of voids in the solder joint interface of flip-chip LEDs. Additional flux is added to the solder paste to reduce...

-
Microstructural evolution and change in macroscopic physical properties of microscale flip chip Cu/Sn58Bi/Cu joints under the coupling effect of electric current stressing and elastic stress
Severe phase coarsening and separation in Sn–Bi alloys have brought increasing reliability concern in microelectronic packages. In this study, a...

-
Thermomigration-induced failure in ball grid array solder joint under high current stressing
In this work, rapid failure of a few minutes was observed in real ball grid array solder joints under high current density (8 × 10 3 and 1 × 10 4 A cm −2 ...

-
Effects of Meshed p-type Contact Structure on the Light Extraction Effect for Deep Ultraviolet Flip-Chip Light-Emitting Diodes
In this work, flip-chip AlGaN-based deep ultraviolet light-emitting diodes (DUV LEDs) with various meshed contact structures are systematically...

-
A Cu Pillar Bump Bonding Method Using Au-Sn Alloy Cap as the Interconnection Layer
High-temperature and flux-free bonding is important for heterogeneous integration of different chips. In this work, a Cu pillar bump was prepared by...

-
Effect of Soldering Temperature on the Reliability of Sn-Ag-Cu Lead-Free Solder Joints
This paper investigates the effect of soldering temperature on solder joint voids and reliability of flip-chip LED chips during reflow soldering....

-
Ultrafast demagnetization and Gilbert dam** in electrodeposited CoP film
From portable electronics to high-performance computing, the requirement for miniaturized and high-efficiency power supply is ever-increasing. Soft...

-
Investigation of Various Bumps and Redistribution Lines to Inhibit Protected Silicon Nitride Cracks in High Pattern Density Chip Package
Mechanical stress related to chip packaging failure is the most common reliability issue in semiconductor devices, especially for high pattern...
-
ACF bonding technology for paper- and PET-based disposable flexible hybrid electronics
In light of the necessity to introduce reliable interconnection technologies for the development of disposable diagnostic kits, fine-pitch flip-chip...

-
Influence of Soldering Temperature on Microstructure and Thermal Properties of FC-LED Filaments Soldered with SAC0307
The influence of the soldering temperature on the performance of flip-chip light-emitting diodes (FC-LED) filaments soldered with SAC0307 has been...

-
Effects of modulation doped n-AlGaN epilayers on the optoelectronic properties of 278-nm AlGaN-based flip-chip light-emitting devices
AlGaN-based deep ultraviolet flip-chip light-emitting diodes (DUV-FCLEDs), have been fabricated by different do** processes in n-AlGaN epilayers,...

-
Effects of ITO Contact Sizes on Performance of Blue Light MicroLEDs
In this study, the effect of ITO contact ratio for blue light micro-light-emitting diode (µLED) with dimensions 40 μm × 40 μm was assessed. The...
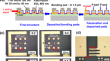
-
RETRACTED ARTICLE: Effect of grain size on the interface structure and shear behavior of lead-free solder joints
This paper investigates the effect of grain size on the evolution and shear behavior of lead-free solder joints. The grain size of the solder is...

-
Optical and thermal performance of nitride-based thin-film flip-chip light-emitting diodes
Nitride-based light-emitting diodes (LEDs) were fabricated based on initial patterned sapphire substrate by thin film (TF) and flip-chip (FC)...

-
Crossbar operation of BiFeO3/Ce–CaMnO3 ferroelectric tunnel junctions: From materials to integration
Ferroelectric Tunnel Junctions (FTJs) are a candidate for the hardware realization of synapses in artificial neural networks. The fabrication process...

-
Performance enhancement of GaN-based near-ultraviolet flip-chip light-emitting diodes with two-step insulating layer scheme on patterned sapphire substrate
Nitride-based near-ultraviolet (NUV) flip-chip (FC) light-emitting diodes (LEDs) on patterned sapphire substrate (PSS) with n-contact full-via-holes...

-
Low-Resistance Room-Temperature Interconnection Technique for Bonding Fine Pitch Bumps
In this work, we demonstrate on a new interconnection technology which can be used for bonding Flip-Chips with 5-µm-Bumps and fine pitches <5 µm. In...

-
Investigating the Reliability of SnAgCu Solder Alloys at Elevated Temperatures in Microelectronic Applications
The demand for miniaturised electronic devices has led to various challenges in microelectronic industries. One of the challenge is the removal of...

-
Bubble formation and growth during Transient Liquid Phase Bonding in Cu/SnAg system for microelectronic packaging
In this work, we study the Transient Liquid Phase Bonding (TLPB) for flip chip interconnexion using copper pillar and SnAg solder alloy technologies....

