Search
Search Results
-
Fracture behavior and mechanical strength of sandwich structure solder joints with Cu–Ni(P) coating during thermal aging
Coating at the interface of solder joint has a great impact on the growth behavior of intermetallic compounds (IMCs) and the mechanical properties....

-
Effects of Near-amorphous multiphase intermetallic compound particles on the microstructure and mechanical properties of SnBi solders
In this study, near-amorphous multiphase intermetallic compound (IMC) particles were prepared with mass percentages of 0, 0.25, 0.5, and 1% to form...

-
Influence of Joint Arrangement on the Fracture Behavior of Lead-Free Solder Joints
The capability to standardize the fracture strength of solder joints is an effective tool to investigate the reliability of electronic devices. To...

-
Effect of Soldering Temperature on the Reliability of Sn-Ag-Cu Lead-Free Solder Joints
This paper investigates the effect of soldering temperature on solder joint voids and reliability of flip-chip LED chips during reflow soldering....

-
Effect of strain rate on mechanical behavior of Sn0.3Ag0.7Cu solder at macro- and micro-scales
At present, there have been many researches on the effect of trace elements on the mechanical properties of Sn–Ag–Cu solder, and the methods used are...

-
Effect of thickness in the SAC 305 plated layer on the interfacial reaction and mechanical properties of the CCSB joint assembled onto the OSP surface finished FR-4 PCB board
The interfacial reaction and the mechanical properties of the Cu core solder balls (CCSB) assembled on the organic solderability preservative (OSP)...

-
Effects of Multiple Impacts on the Microstructure and Dynamic Mechanical Properties of SAC0307 Alloy
Electronic products often suffer from impact loadings and fall during use, resulting in internal solder joints that interact with each other under a...

-
Electromigration behavior of Cu/Sn3.0Ag0.5Cu/Cu ball grid array solder joints
Electromigration (EM) behavior induced by current crowding under the condition of multi-physical fields in Cu/Sn3.0Ag0.5Cu/Cu ball grid array (BGA)...

-
Characteristic morphologies that cause failure of Au80Sn20/AlN substrate solder joint under combined temperature cycle and current switch cycle tests
With the requirement of lead-free soldering technology in electronic industry for manufacturing lead-free electronic devices, Au80Sn20 solder has...

-
Influence of copper nanowires on properties and microstructure of low-Ag Sn-1Ag-0.5Cu solders
In this paper, copper nanowires (Cu NWs) were mixed into the Sn1.0Ag0.5Cu solder to improve the properties of Sn1.0Ag0.5Cu solder and change the...

-
The Evolution of IMCs in Single Crystal Sn3.0Ag0.5Cu and Sn3.0Ag3.0Bi3.0In BGA Solder Joints with Au/Ni/Cu Pads Under Current Stressing
The growth behavior of intermetallic compound (IMC) in single crystal Sn3.0Ag0.5Cu (SAC305) and Sn3.0Ag3.0Bi3.0In (SABI333) ball grid array solder...
-
Solid-state diffusion studies of lead-free solders on gold and in polymer films
Lead-free solders are commonly used in microelectronic packages in chip and board level interconnections. They primarily interact with other metals...

-
Effect of grain boundary on failure behavior of SABI333 solder joints during creep
Sn 3.0 Ag 3.0 Bi 3.0 In (SABI333) solder is easy to form solder joints with different crystal structures during solidification. Solder joints with...

-
Effect of extreme thermal shocking on the reliability of Sn50Pb49Sb1/Cu solder joint
The cosmic extreme temperature is deemed to be an enormous problem for the electronic devices and solder joints of on-orbit satellite. In this paper,...

-
Study on Thermal Shock and Annealing Behavior of Sn3Ag0.5Cu-TSV Prepared by Modified Molten Metal Infiltration Method
Filling and reliability of through-silicon via (TSV) are critical issues in the industrialization of TSV. In this study, Sn3.0Ag0.5Cu (SAC305) solder...

-
Detrimental angle range between c axis of Sn crystal and electron flow for the electromigration reliability of ball grid array devices
With the rapid development of miniaturization and high integration for electronic components, the increasing current density and Joule heat put a...

-
Transient liquid phase bonding of Cu@Sn core–shell particles with added Sn–3.0Cu–0.5Ag
A 3–5 μm Cu@Sn core–shell powder was prepared by chemical plating. Based on the mixture of this Cu@Sn and SAC305 powder, a solder material for...
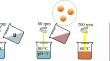
-
A review of interconnect materials used in emerging memory device packaging: first- and second-level interconnect materials
The main motivation of this review is to study the evolution of first and second level of interconnect materials used in memory device semiconductor...

-
Influence of benzotriazole on electroplated Cu films and interfacial microstructure evolution of solder joints
Benzotriazole (BTA), a nitrogen-containing heterocyclic compound, was employed as a leveler to prepare Cu film. During electroplating, the...

-
Effect of Cu6Sn5 nanoparticle on thermal behavior, mechanical properties and interfacial reaction of Sn3.0Ag0.5Cu solder alloys
This work studied the additions of nano-Cu 6 Sn 5 intermetallic particles into a lead-free Sn3.0Ag0.5Cu (SAC305) solder alloy with content ranging from...

