Search
Search Results
-
A Cu Pillar Bump Bonding Method Using Au-Sn Alloy Cap as the Interconnection Layer
High-temperature and flux-free bonding is important for heterogeneous integration of different chips. In this work, a Cu pillar bump was prepared by...

-
Wetting behavior of eutectic Au–Sn solder on Ni/Au metallization at different temperatures
Au–Sn solder is a high reliable lead-free solder with excellent oxidation resistance which is commonly used in fluxless soldering. In this paper, the...

-
Effect of Ni on the Au embrittlement in Sn/Au/Ni solder bump
The effect of Ni on the gold embrittlement in the Sn/Au/Ni solder bump was studied in this paper. The mechanical properties of (Au 1−x ,Ni x )Sn 4 ( x = 0,...

-
Microstructure and shear strength of Au-20wt%Sn solder joints fabricated by thermo-compression bonding for LED packages
Solder joints of Au-20wt%Sn (Au-20Sn) between real light-emitting diode Si chips and AlN substrates were fabricated using thermo-compression (TC)...

-
Grain Boundary Diffusion of Ni through Au-Doped Ni3Sn2 Intermetallic Compound for Technological Applications
In recent years Au-Sn solid–liquid interdiffusion (SLID) has become a widely known bonding method to deliver promising die attaching techniques for...

-
In situ TEM Characterization of Phase Transformations and Kirkendall Void Formation During Annealing of a Cu–Au–Sn–Cu Diffusion Bonding Joint
Diffusion bonding with Au, Cu and Sn is a technique that can be used to manufacture printed circuit boards. The mechanisms of reactive diffusion and...

-
Effect of the Welding Process on the Microstructure and Mechanical Properties of Au/Sn–3.0Ag–0.5Cu/Cu Solder Joints
This paper investigates the influence of the welding process on the microstructure and mechanical properties of Au/Sn–3.0Ag–0.5Cu/Cu solder joints....

-
Effect of Ni, Zn, Au, Sb and In on the Suppression of the Cu3Sn Phase in Sn-10 wt.%Cu Alloys
Since manufacturing is transitioning into Pb-free solder development for electronic assembly and packaging, consumer demands for more compact...

-
Comparative study of laser- and reflow-soldered Sn–3.0Ag–0.5Cu joints on thin Au/Pd/Ni(P) substrate
High-precision and high-density bonding methods are gaining research interest owing to need for the miniaturization of semiconductor devices and...

-
Research on Microstructure and Shear Behavior of Au/Sn-Ag-Cu/Cu Lead-free Solder Joints at Different Soldering Temperatures
In the actual production process, soldering is a key step in the flip-chip packaging process. The reliability of the interconnection interface of...

-
Comparative study of normal and thin Au/Pd/Ni(P) surface finishes with Sn–3.0Ag–0.5Cu solder joints under isothermal aging
A comparison study of the interfacial reactions and mechanical shear strengths of normal and thin electroless-nickel electroless-palladium immersion...

-
Increasing shear strength of Au–Sn bonded joint through nano-grained interfacial reaction products
Intermetallic compounds (IMCs) form at the solder/substrate interface during soldering, providing metallurgical bonding. However, cracks tend to...

-
Effects of Ni(P) layer thickness and Pd layer type in thin-Au/Pd/Ni(P) surface finishes on interfacial reactions and mechanical strength of Sn–58Bi solder joints during aging
To analyze the effects of Ni(P) layer thickness and Pd layer composition on interfacial reactions and the mechanical reliabilities of Sn–58Bi solder...

-
The Effect of Thermal Aging on the Mechanical Properties of Gold-Containing Solder Joints
The reliability of SnPbAg solder joints containing gold (Au) under different aging conditions have been investigated. The solder joints were prepared...

-
Interface Embrittlement Between 63Sn-37Pb Solder and Au Layer. Part 2: Quantitative Compositional Analysis of Intermetallic Compound Reaction Layers
The interface gold (Au) embrittlement failure mode resulting when a Au protective finish is not completely removed by the soldering process. has been...

-
Pulse electric current induced interfacial ductile phase on improving the mechanical properties of the Au20Sn/Cu solder joints
Forming ductile phase is an effective way to release stress localization and suppress crack initiation in interfacial reaction products, which...

-
Effect of Au Do** on Elastic, Thermodynamic, and Electronic Properties of η-Cu6Sn5 Intermetallic
The effects of substitution of Au for Cu on the elastic, thermodynamic, and electronic properties of hexagonal η-Cu 6 Sn 5 intermetallic compound (IMC)...
-
Interface Embrittlement Between 63Sn-37Pb Solder and Au Layer—Part 1: Physical Metallurgy of Liquid-State and Solid-State Reactions
This study examined the interface microstructure that developed between 63Sn-37Pb (Sn-Pb) solder and the Au protective layer that was not fully...
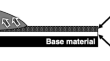
-
Application of metal interconnection process with micro-LED display by laser-assisted bonding technology
Bonding between the micro-LED chip and the substrate soldered joint has become a key bottleneck after the mass transfer process of moving individual...

-
Au nanoparticle-modified ZnO/SnO2 heterojunction nanocomposites for highly sensitive detection of NH3
The development of resistive NH 3 gas sensor detection technology has important practical significance for environmental protection and human health...

